当前,关于摩尔定律放缓的讨论越来越多。而随着以数据为中心的时代到来,对芯片算力、功耗、内存带宽都提出了更高的要求,实现芯片的每瓦更高性能及更低成本至关重要。
作为处理器和主板之间的物理接口,封装为芯片和电信号和电源提供了着陆区,同时也起到固定、密封、保护芯片等作用。随着芯片功能的增加和体积的增大,芯片设计、测试以及制造的难度陡然增加,封装作为在摩尔定律接近极限的情况下可以进一步提升芯片性能的技术环节,受到了越来越多的关注。奥芯明凭借其先进封装技术解决方案,悄然引领着数据中心的变革
先进光子集成技术引领数据中心新变革
在光通信领域,奥芯明专注于先进的光子集成技术,特别是在共封装光学(CPO:Co-Packaged Optics)方面的创新。相较于传统通过Pluggable和NPO实现光电转换功能,CPO技术将激光器、调制器、光接收器等光学器件封装在芯片级别上,直接与芯片内的电路集成。通过缩短交换芯片与光引擎之间的距离,CPO技术借助光互联提高电信号在芯片和引擎之间的传输速度,继而提升通信系统的性能和功率效率。
CPO在高集成度、降低电磁干扰、降本升效、适应高速高密度传输需求等方面皆对数据传输产生了重要影响。凭借先进的CPO解决方案,奥芯明助力客户在数据中心和电信网络中实现更高的带宽和更低的延迟,显著提升了网络的传输效率、降低了功耗,推动数据中心的持续发展。
CoC-embedded CPO:奥芯明将激光COC直接附着在光子集成电路(PIC)上,通过整合电子集成电路(EIC)和光学元件,形成高效的光学引擎(OE)。这种创新的封装技术大大缩短了计算源和通信源之间的铜迹线长度,降低了功耗损失和信号失真,特别是在高频调制下表现尤为突出。
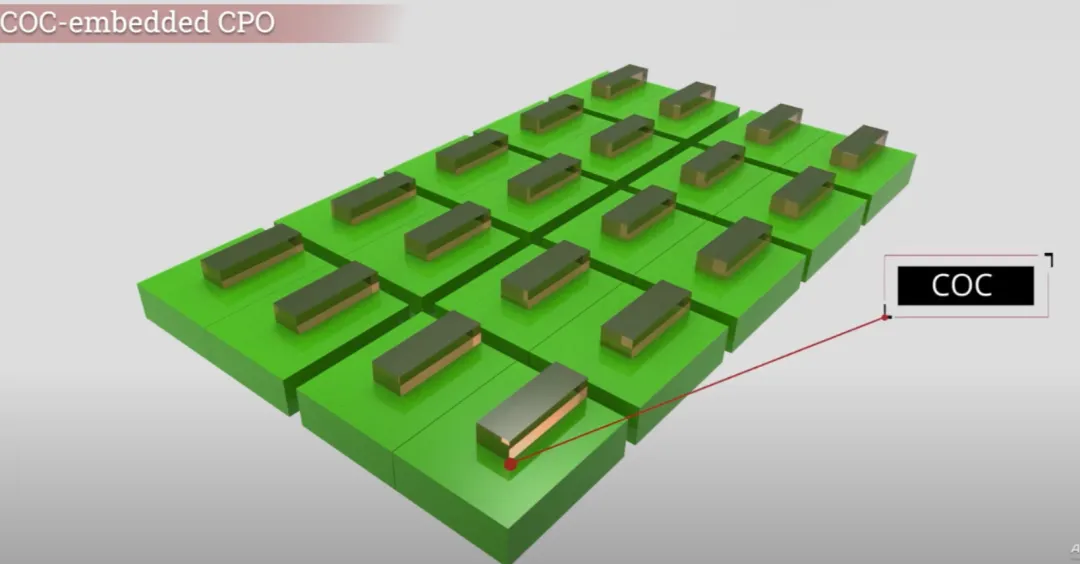
CPO with ELSFP:采用外部激光SFP(Small Form-factor Pluggable)模块作为信号载体,奥芯明的这一方案将激光光源置于面板外部的SFP中,调制则保持在CPO内部。这种设计不仅保持了CPO的功能,还有效隔离了热源,提高了CPO开发和部署的可行性。
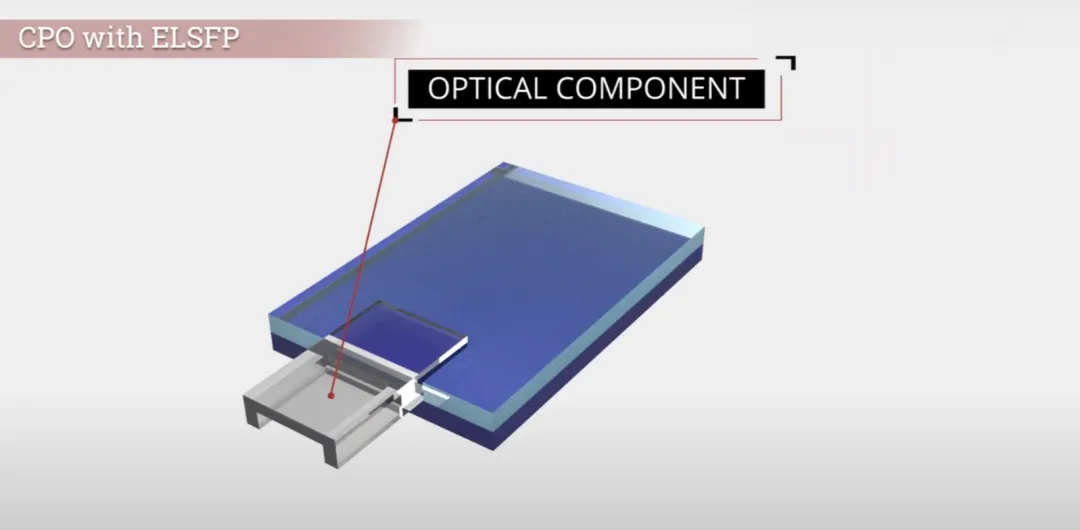
卓越封装与内存解决方案提升计算能力
在高性能计算领域,奥芯明展示了其在先进封装和内存解决方案方面的卓越能力。奥芯明提供的封装技术不仅具有高密度、高性能的特点,还支持大数据应用所需的强大计算能力。通过提供卓越的封装和内存解决方案,奥芯明助力客户在高性能计算领域取得更大的突破和创新
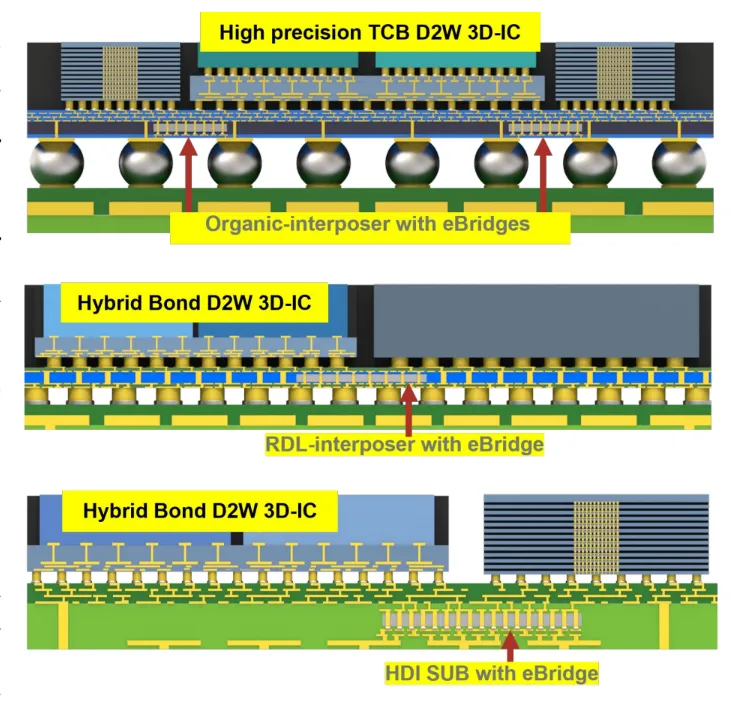
热压键合机(TCB Bonders)
作为PC和服务器中端逻辑芯片组装的关键技术,热压键合(TCB)从芯片到基板(C2S)、芯片到晶圆(C2W)逐步进化,现已成为超精密、高吞吐量的可扩展解决方案。它能够满足未来行业和客户的需求,提升组装精度和效率,增强芯片的可靠性和性能。
ASMPT在热压键合领域拥有业内领先的技术优势,其中包括:
全球领先的精细化控制能力,包括温度、时间、力还有高度等;
主动的倾斜控制系统,能够实现较高的平行度控制;
无助焊剂热压键合(Fluxless TCB)技术:
·ASMPT是全球开创具有惰性气体保护环境的TCB机台的公司,所有型号都有氮气保护,这成为Fluxless技术可以实现的基础和前提。此外,这项技术还可以处理30微米甚至更薄的芯片,并通过规避氧化问题来提高产品良率和互连密度,进而提高HBM堆叠层。
·Firebird系列机型主要针对先进TCB技术应用,主要机型包括FB-SW、FB-XD、FB-W2P等,可以处理不同的产品要求。
HBM封装技术
高带宽内存(HBM)作为一种新型的内存技术,因其高数据传输速率和低功耗特点,广泛应用于图形处理单元(GPU)、深度学习加速器和高性能计算(HPC)等领域。HBM允许芯片以更高的速度处理数据,这在当今数据暴增的时代显得尤为重要。
针对这一市场需求,ASMPT的热压键合技术能够有效提升HBM模块的生产效率和质量,通过温度控制和精细的焊接工艺,确保多层芯片之间的连接牢固。通过将多个芯片封装在一起,HBM显著提升了存储性能和容量,优化能效,为AI和大数据处理提供了强有力的支持。
随着人工智能、5G、云计算等技术的发展,HBM的市场需求将持续增长。尤其是在人工智能领域,数据处理速度和存储速度的提升将直接影响到AI模型的训练效率。作为奥芯明封装设备的重要应用领域之一,数据中心的快速发展和广泛应用对奥芯明的产品不断提出新的技术要求,而奥芯明也将通过技术积淀和创新不断推陈出新,推动数据中心在速度、能耗以及运算和存储能力上的持续进步。
文章转载于公众号【 奥芯明 奥芯明】